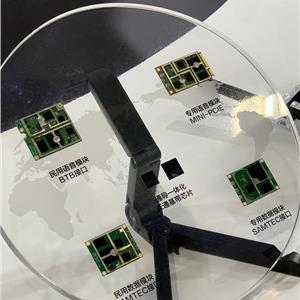
芯片封装
与“芯片封装”的相关热搜词:
相关“芯片封装” 的资讯176篇
-
【腾讯云】11.11云上盛惠!云服务器首年1.8折起,买1年送3个月!
11.11云上盛惠!海量产品 · 轻松上云!云服务器首年1.8折起,买1年送3个月!超值优惠,性能稳定,让您的云端之旅更加畅享。快来腾讯云选购吧!
 腾讯云
12-20
广告
腾讯云
12-20
广告 -
三星将推出先进的 3D AI 芯片封装技术 SAINT 与台积电竞争
三星电子计划于明年推出一项先进的三维芯片封装技术,以与代工龙头台积电展开竞争。总部位于韩国水原市的这家芯片制造商将使用该技术——SAINT——来集成高性能芯片所需的存储器和处理器,包括AI芯片,并大幅减小其尺寸。三星的新SAINT技术旨在提高数据中心和移动APs中AI芯片的性能,这些APs具有设备内AI功能,消息人士表示。
-
三星电子计划将300三星显示员工调整至芯片封装业务部门
将显示业务部门的部分员工调整到芯片封装业务部门,三星电子也是希望能充分利用内部的优秀员工,推动芯片业务的发展,同时的芯片业务部门,也面临人才方面的挑战,需要更多的员工...外媒在报道中表示,三星集团计划投资的450万亿韩元,大部分将投向芯片业务,包括存储芯片、逻辑芯片和晶圆代工业务,芯片业务部门对员工也有很大的需求......
-
英特尔展示14代Meteor Lake芯片封装 融合CPU、GPU与IO小芯片
在今日的 VISION 活动期间,英特尔还向与会媒体们披露并展示了采用标准和高密度封装方案的第 14 代 Meteor Lake 处理器...除了 Meteor Lake,Chipzilla 还展示了四瓦片封装的英特尔 Sapphire Rapids 芯片(无 HBM / 带 HBM 版本),以及基于 Xe-HPC 旗舰 GPU 架构的 Ponte Vecchio 加速芯片......
-
立讯精密和歌尔已开始或准备为苹果提供芯片封装服务
据Nikkei Asia报道,知情人士称苹果公司两家重要的产品组装厂商立讯精密(Luxshare)和歌尔,已开始或准备为苹果提供芯片封装服务...立讯精密正在为苹AirPods无线耳机提供芯片「系统级封装」(SiP)服务...
-
华为“芯片封装组件”发明专利公开:可使芯片有效散热 降低安全隐患
企查查页面显示,华为技术有限公司于11月26日公开了一项申请的发明专利,内容为芯片封装组件、电子设备及芯片封装组件的制作方法”。发明人为彭浩、廖小景、侯召政,处于审中状态。摘要中介绍,芯片封装组件包括封装基板、芯片和散热部,封装基板包括上导电层、下导电层和连接在上导电层和下导电层之间的导电部;芯片包括相背设置的正面电极和背面电极,芯片内嵌在封装基板内,导电部包围芯片,正面电极与下导电层连接,背面电极与
-
三星LPDDR5 UFS多芯片封装开启量产:本月进入国内市场
6月16日消息,今日上午,中国三星官方通过微博宣布,本月开始,三星首款LPDDR5 uMCP将量产并用于中高端智能手机。官方表示,目前,三星已经顺利完成了LPDDR5 uMCP与几家全球智能手机制造商的兼容性测试,并预计从本月起,配备了新款LPDDR5 uMCP的智能手机即将进入中国市场。据了解,基于UFS多芯片封装的LPDDR5,相比上一代产品,三星uMCP集成了目前三星产品中最快的LPDDR5 DRAM和最新的UFS 3.1 NAND闪存,可谓更多的智能手机用户提
-
三星电子:已开始量产基于LPDDR5 UFS的多芯片封装
三星电子今天宣布,已开始量产其最新的智能手机内存解决方案,即基于LPDDR5 UFS 的多芯片封装 (uMCP)。三星的 uMCP 集成了最快的 LPDDR5 DRAM 和最新的 UFS3.1 NAND 闪存。
-
供应链已向苹果送样 AirPods3 等芯片封装
日前分析师郭明錤在最新预测报告中表示,新 AirPods 要到2021年第三季度才会量产。他预测,AirPods2在今年第三季度的出货量将显著减少至约300万部(去年 Q3位1200万部),主要原因可能是产品转换,即新一代 AirPods 的推出。现在据供应链消息,供应链环旭电子已向苹果送样 AirPods3/AirTags 等芯片封装。环旭电子为日月光集团旗下环隆电气控股子公司,日月光集团为全球规模最大之芯片封测公司。
-
台积电计划明后两年新投产两座芯片封装工厂 采用3D Fabric封装技术
据国外媒体报道,台积电近几年在芯片代工方面走在行业前列,他们的技术水平领先,也获得了大量的芯片代工订单,苹果、AMD等诸多公司的芯片,都是交由台积电代工。但除了芯片代工业务,台积电其实也有芯片封装业务,他们旗下目前就有多座芯片封装工厂,还在不断研发新的封装技术,建设更先进的芯片封装工厂。外媒最新的报道显示,台积电计划明后两年新投产两座先进的芯片封装工厂。台积电官网的信息显示,
-
不只是芯片代工 外媒称台积电三星还将在芯片封装领域展开激烈竞争
9月15日消息,据国外媒体报道,台积电和三星是目前全球最大的两家芯片代工商,近几年台积电在制程工艺方面领先,7nm和5nm工艺都是率先推出,良品率也相当可观,台积电也因此获得了大量的订单。而外媒最新的报道显示,在芯片代工方面竞争激烈的台积电和三星,在芯片封装方面还将展开激烈的竞争。事实上,三星和台积电在芯片封装测试方面将展开激烈竞争的消息,在上月底就已出现,当时外媒援引产业链消息人士的透露报道?
-
三星加快部署3D芯片封装技术 希望明年同台积电展开竞争
8月24日消息,据国外媒体报道,本月中旬,三星展示了他们的3D芯片封装技术,而外媒最新的报道显示,三星已加快了这一技术的部署。外媒是援引行业观察人士透露的消息,报道三星在加快3D芯片封装技术的部署的。加快部署,是因为三星寻求明年开始同台积电在先进芯片的封装方面展开竞争。从外媒的报道来看,三星的3D芯片封装技术名为“eXtended-Cube” ,简称“X-Cube”,是在本月中旬展示的,已经能用于7nm制程工艺。三星
-
外媒:iPhone 7采用新型芯片封装技术 再也不说抄三星了
产业界消息称,苹果iPhone 7会采用新型芯片封装技术,会使iPhone 7的机身更加轻薄,电池容量也会增加,信号损耗相应减少。一位产业界代表透露,苹果此前残用过类似做法,不过这次用的地方不同。
-
传苹果与芯片封装厂商会谈 拟明年发A6处理器
北京时间8月27日消息,据国外媒体报道,据中国台湾地区科技新闻网站DigiTimes报道称,据悉,苹果最近与芯片封装和测试厂商矽品精密(Siliconware Precision Industries)进行会谈。
-
Semron筹集790万美元,用于移动设备的3D封装AI芯片、效率提升20倍
德国公司Semron最近成功融资了790万美元,旨在通过先进的3D封装技术推动移动设备上的AI芯片效率提升。总部位于德累斯顿的Semron表示,他们的目标是在移动设备上设立新的AI芯片标准,以满足行业不断发展的需求。到目前为止,该公司已经融资1090万美元,并拥有11名员工。
-
预期英伟达明年将推出新一代 AI 芯片架构 加速 CoWoS 封装需求
AI芯片的需求正在带动先进封装技术的发展,英伟达等大厂积极布局2.5D先进封装技术。其中CoWoS封装技术是关键,但产能仍然短缺,影响了包括英伟达在内的大厂AI芯片出货进度。随着新一代B100制图芯片架构的推出,英伟达将采用台积电的4纳米制程和结合2颗GPU晶粒和8颗高频宽内存的方式来加速CoWoS先进封装的需求。
-
三星电子将为英伟达最新的人工智能芯片 H100 提供 HBM3 和封装服务
据韩国经济日报消息,存储芯片制造商三星电子将为英伟达公司提供高性能半导体和封装服务,有望在其它大型科技公司中赢得订单。根据周二首尔的行业消息,三星和英伟达正在对 HBM3 芯片进行技术验证和封装服务。一旦完成工作,预计三星将负责封装 H100,英伟达最新的人工智能 GPU,同时为处理器供应 HBM3 芯片。
-
消息人士透露台积电紧急订购封装设备 以满足英伟达AI芯片需求
ChatGPT等人工智能应用需求的增加,拉升了对英伟达H100、A100等高性能GPU的需求,这也促使他们增加在晶圆代工商台积电订单,以满足客户的需求。英伟达增加在台积电的订单,也推升了台积电先进制程工艺的产能利用率。在先进制程工艺的产能利用率提升的同时紧急预订封装设备,也就意味着台积电将成为英伟达人工智能芯片需求增加的一大受益者,在芯片市场仍不乐观的大背景下,能显著改善他们的营收。
-
苹果5G芯片要来:就等着封装了
苹果的5G芯片已经研发多年,据新的一份报告称,苹果的5G芯片已经设计完成,并有多家供应商有意协助完成芯片的最终组装。DigiTimes爆料的消息称,ASE Technology和Amkor Technology正在“竞争”苹果公司的封装调制解调器芯片,这两家公司已经有了封装高通调制解调器芯片的经验。高通是苹果设备的5G调制解调器的独家供应商,包括整个iPhone 14系列,但一直有传言称苹果正在设计自己的5G芯片作为公司内部替代品。
-
苹果5G芯片就绪!已经有公司抢着封装了
据传Apple正在进行5G调制解调器项目,并有多家供应商有意协助完成芯片的最终组装。尽管这款定制设计的调制解调器可能会由苹果的芯片制造合作伙伴台积电进行生产,但最终的封装阶段可能会由其他供应商处理。高通是苹果设备的5G调制解调器的独家供应商,包括整个iPhone 14系列,但一直有传言称苹果正在设计自己的5G芯片作为公司内部替代品,彭博社的Mark Gurman报告称,苹�
-
DigiTimes:联发科将于2023年量产CoWoS封装的HPC芯片 用于元宇宙等领域
据DigiTimes报道,据供应链消息人士称,联发科将在2023年采用先进工艺节点和CoWoS封装技术,量产新高性能运算芯片,该芯片将由台积电代工,用于元宇宙、AIoT等领域...消息人士称,联发科正在积极跨入HPC领域,它将采用台积电3D Fabric平台下的CoWoS技术,对自己的HPC芯片和客户从其他供应商购买的高带宽内存芯片进行异构整合,小批量生产将在2022年底前启动,然后在2023年提升产量...
-
全新叠层封装麒麟芯片 华为P60 Pro+概念图
近日,有爆料人曝光了华为P60 Pro+的概念图,整体继承了华为P系列手机的设计语言和风格。这套图倒还好,但其曝光的华为P60 Pro+的配置才是重点。据悉这款华为P60 Pro+搭载了华为自研的全新一代麒麟芯片,据悉这颗自研芯片采用了国产自研的14nm叠层封装工艺,同时集成了华为自研的CPU和GPU架构。华为P60 Pro+将鸿蒙3.0系统+IP68防水+5000mAh电池以及100W超级快充,基本都算是华为P系列的常规操作了。正面搭载一块2K分辨率的6.72英寸京东方蜂窝LTPO屏幕。整体上自研叠层封装的国产芯片更让人期待。华为P60 Pro+将采用无边界四曲面屏幕以及1?
-
Hot Chips预告:英特尔将展示Foveros 3D封装的Meteor/Arrow Lake芯片
在大家将目光普遍聚焦于 Computex 2022 台北电脑展的Tom's Hardware 又预告了英特尔将在 8 月份的 Hot Chips 34 大会上展示 Foveros 3D 封装的 Meteor / Arrow Lake 芯片的消息...此外在全虚拟展示期间,该公司还会讨论 Ponte Vecchio GPU 相关的架构、系统与软件解决方案,以及一些 Xeon D 和 FPGA 演示...感兴趣的朋友,可移步至 Hot Chips 官网以了解详情...
-
苹果在三星的帮助下继续研发M2芯片 由后者提供FC-BGA封装
据ET News报道,苹果公司在三星电子的帮助下,正在继续其即将推出的M2芯片的工作...三星将为M1芯片提供倒装芯片球栅阵列(FC-BGA),这是一种用于连接半导体芯片和主基板的印刷电路板...该报告重申了Mark Gurman的说法,即苹果正在测试至少九款新Mac,并采用四种不同的M2芯片型号,首批采用M2的设备可能在2022年上半年亮相...
-
华为公开“一种芯片堆叠封装及终端设备”专利
4月5日消息,据国家知识产权局官网消息,今日,华为公开了一种芯片堆叠封装及终端设备专利,可解决因采用硅通孔技术而导致的成本高的问题。专利摘要显示,该专利涉及半导体技术领域,其能够在保证供电需求的同时,解决因采用硅通孔技术而导致的成本高的问题。面对消费者业务的持续制裁,华为正在为芯片供应问题寻找新的解法。此前,在2021年华为财报发布会上,郭平表示,未来的芯片布局,我们的主力通信产品采用多核结构,支撑软件架构的重构和性能的倍增。郭平还指出,华为要进行系统架构的优化、软件性能的提升和理论的探索。同时通过解
-
用堆叠换性能!华为芯片堆叠封装专利公开:降低硅通孔技术成本
华为公开了一种芯片堆叠封装及终端设备专利,申请公布号为CN114287057A,可解决因采用硅通孔技术而导致的成本高的问题...专利摘要显示,该专利涉及半导体技术领域,其能够在保证供电需求的解决因采用硅通孔技术而导致的成本高的问题...采用面积换性能,用堆叠换性能,使得不那么先进的工艺也能持续让华为在未来的产品里面,能够具有竞争力...也就是说,可以通过增大面积,堆叠的方式来换取更高的性能,实现低工艺制程追赶高性能芯片的竞争力......
-
AMD、Intel等组建UCIe封装技术联盟 国产芯片厂商芯原首次加入
Chiplets小芯片封装(也有翻译称之为芯粒)技术是近年来的热门,将不同IP模块封装在一起可以进一步提高芯片性能,此前AMD及Intel等公司还组建了UCIe产业联盟,现在芯原股份也加入了该联盟,成为第一个加入的国产芯片厂商...芯原股份是国内领先的芯片IP服务商,该公司日前宣布宣布正式加入UCIe产业联盟...作为中国大陆首批加入该组织的企业,芯原将与UCIe产业联盟其他成员共同致力于UCIe 1.0版本规范和新一代UCIe技术标准的研究与应用,为芯原Chiplet技术和产品的发展进一步夯实基础......
-
苹果的M1 Ultra芯片采用台积电CoWoS-S封装工艺
据报道,为了改善风险管理,苹果将依靠台积电制造其最新的 M1产品,采用的先进解决方案集成了5nm 芯片技术和 CoWoS-S(chip-on-wafer-on substrate with silicon interposer)封装工艺......
-
苹果 M1 Max 芯片隐藏预留部分 未来或可组成多芯片MCM封装
从公开的照片来看,苹果 M1Max 芯片与官方公布的渲染图不同,这款芯片边缘部分还有较大的一部分区域,没有在渲染图中显示。这名用户表示,仅需将这块芯片翻转,便可以与同款芯片互联,组成 MCM 多芯片封装架构,进一步提高性能。而 M1Pro芯片并没有预留这个区域。
-
台积电公布先进CoWoS封装技术路线图 2023年结合小芯片与HBM3
在 HotChips33 年度会议期间,台积电介绍了该公司最先进的封装技术路线图,并且展示了为下一代小芯片架构和内存设计做好准备的最新一代 CoWoS 解决方案。WCCFTech 指出,这家业内领先的半导体巨头在先进芯片封装技术方面取得了快速进展。过去十年,该公司已经推出五代不同的基板上芯片封装工艺,且涵盖了消费级与服务器芯片领域。预计 TSMC 将于今年晚些时候宣布第 5 代 CoWoS 封装技术,其有望将晶体管数量翻至第 3 代封装解决方?
-
AMD申请了基于MCM模块化芯片设计专利,GPU将采用多核封装
据wccftech报道,AMD 于2020年12月31日向美国专利及商标局提交了一份专利申请,展现了全新的模块化 GPU 设计方法。该图形芯片令人回想起基于MCM的CPU设计。





